Einer der Gründe der hohen Zuverlässigkeit und Ausbeute der automatischen Drahtbondverfahren, ist eine maximale Homogenität der Drahteigenschaften; eine hohe homogene chemische Zusammensetzung und stabile mechanische Eigenschaften in diesen Drähten. Diese Eigenschaften können während des Lötprozesses der Drähte zu den Drahtkissen durch die aufgebrachte Wärme beeinflusst werden. Der Drahtbereich, der durch die Wärme beeinflusst wird, wird mechanisch schwächer, was die Ausbildung der Drahtschleife und ihre Stabilität verändern kann.
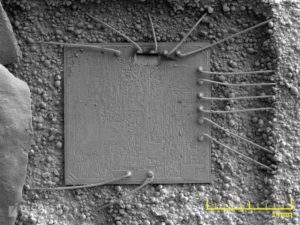
Blick auf ein Wire Bonding eines Halbleiterchips nach chemischer Entkapselung
- REM-Techniken erlauben die Ausübung verschiedener Tests bei Drahtanschlüssen. TESCANs patentierte, Wide Field Optics™ erlaubt die Abbildung extragroßer Objekte. Ganze Chip-Einheiten mit freigelegten Drahtanschlüssen bei niedriger Vergrößerung sind darstellbar.
- Die hohe Leistungsfähigkeit der MIRA3 Elektronensäule ermöglicht hohe Elektronenströme, welche für verschiedene Analysetechniken wie EDX und WDX notwendig sind. Diese sind essentiell, um metallurgische Untersuchungen der Bonddrähte durchzuführen. Die gebildeten intermetallischen Schichten, die an den Bonddrahtgrenzflächen vorhanden sind, oder den Einfluss der Korngrößenverteilung auf den Bondprozess können damit untersuchen werden.
- TESCAN FIB-REM-Systeme erweitern die analytischen nano- und mikroskaligen Möglichkeiten. Damit lassen sich Bonddrähte zu untersuchen, um deren Verbidung und Metallisierung zu untersuchen.
- TESCAN LYRA3 und GAIA3 verfügen über eine Ga-Ionenquellen-FIB-Säule für das ortsspezifische Schneiden mit hervorragender bildgebender Auflösung. FERA3 und XEIA3 mit Xe-Plasmaionen-FIB-Säule ist die beste Wahl um große Querschnitte in kurzer Zeit ermöglichen.
- REM-Untersuchungen und FIB-Querschnitte können ebenfalls verwendet werden, um die Auswirkung von hohen Temperaturen auf Bonddrähte, wie metallurgische Veränderungen, Hohlräume und Abnahme der Haftfestigkeit, zu untersuchen.
- Zusätzlich können Zug- und Druckmodule und ein Nanoindenter zur Durchführung von in-situ-Belastungstests in Draht- und Drahtbondqualität verwendet werden.
- Different cross-sections prepared by Xe plasma FIB: A trench prepared for 3D tomography
- Crosssection of a ball bond and bond pad
- Wire bonds embedded in resin
- Cross-section ball bonds embedded in resin
- Magnified image of Cu bond showing a crack at the interface causing failure